据“深圳大学材料学院”官微消息,在第37届功率半导体器件与集成电路国际会议(IEEE ISPSD 2025)上,深圳大学材料学院刘新科研究员团队的三项研究成果成功入选,其中一项作为口头报告展示,两项以海报形式展出。
GaOx界面技术助力氮化镓MOS电容器性能提升
研究团队通过氢化物气相外延技术,制备了低位错密度(约1.5×10⁶ cm⁻²)的单晶氮化镓衬底及其外延层,用于制造高质量垂直氮化镓MOS电容器。团队引入了一种创新的GaOx界面技术,在Al₂O₃/GaN界面处沉积一层薄薄的氧化镓作为中间层。实验结果显示,该技术显著降低了界面陷阱密度(Dit)至约8×10¹⁰ cm⁻² eV⁻¹,栅极漏电流得到有效抑制,同时钝化了氮和氧相关的空位及悬挂键。该成果为垂直氮化镓MOSFET的开发提供了新思路,相关论文由硕士生林锦沛担任第一作者。
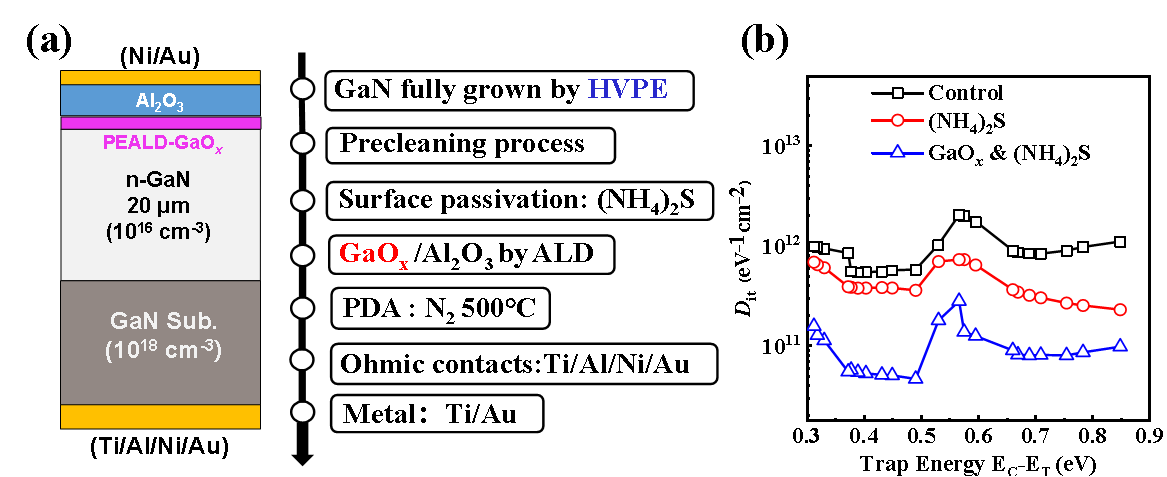
图源:深圳大学材料学院
图中展示了具有GaOx界面层的垂直GaN MOS电容(a)结构示意图及关键工艺,(b)器件的界面态密度参数提取。
He离子注入技术提升氧化镓功率二极管性能
研究团队开发了一种高稳定性的垂直结构NiO/β-Ga₂O₃异质结二极管,通过氦原子注入技术构建边缘终端结构,成功将击穿电压从1330 V提升至3000 V,巴利加优值达到3.10 GW/cm²。研究还采用氧气退火工艺,将比导通电阻从5.08 mΩ·cm²降低至2.90 mΩ·cm²,进一步提升了器件稳定性。该成果由博士生韩甲俊担任第一作者,并在会议现场进行了口头汇报。
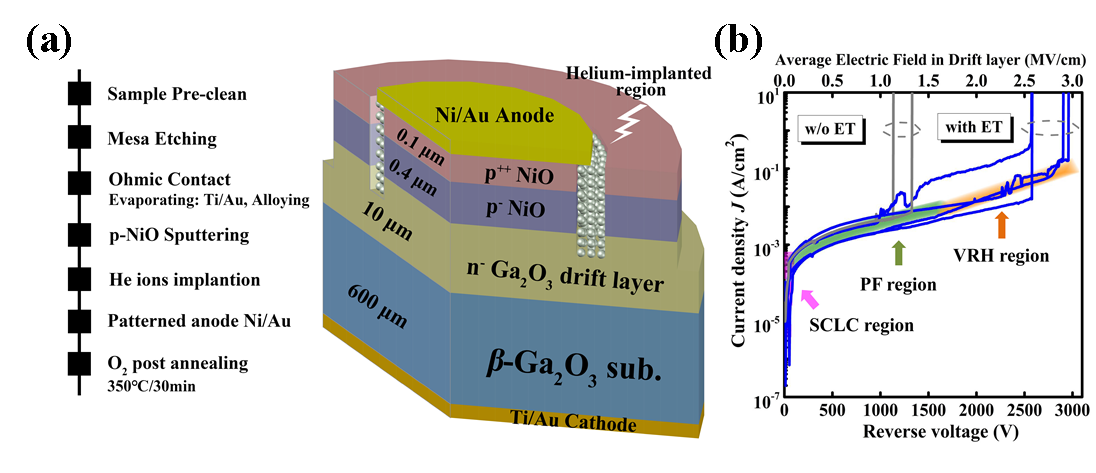
图源:深圳大学材料学院
图中展示了具有He离子注入终端的β-Ga₂O₃ HJDs(a)截面示意图和制造关键工艺,(b)反向击穿特性曲线。
垂直p-NiO/n-GaN二极管性能优化
团队还报道了一种高性能垂直p-NiO/n-GaN异质结二极管。通过氧气等离子体处理(OPT)和氧气后退火工艺,研究显著降低了接触电阻至3.84×10⁻⁶ Ω·cm²,击穿电压提升至1135 V,优值达到0.23 GW/cm²。硕士生黄烨莹和王敏为该论文的共同第一作者。
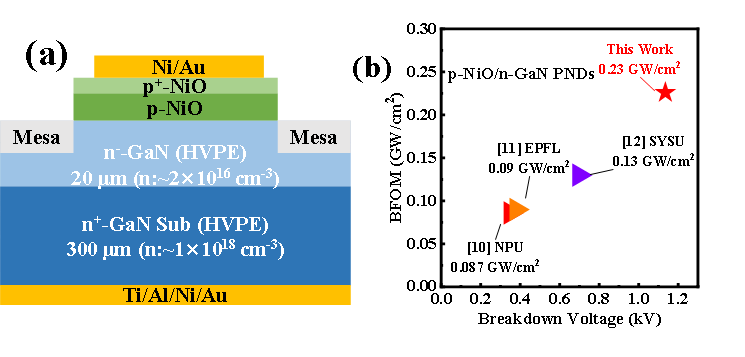
图源:深圳大学材料学院
图中展示了NiO/GaN垂直pn HJD的结构示意图(a),以及之前报道的NiO/GaN PND的FOM与击穿电压的对比(b)。

